Equipment

Unser Labor bietet Studierenden praxisnahes Arbeiten an modernen Leistungselektronikmodulen. Von der Laminierung über Packaging bis hin zur Analyse lernen sie, wie Materialien, Schichtaufbauten und Fertigungsverfahren die Leistung, Zuverlässigkeit und Effizienz von Modulen beeinflussen. Mit modernster Ausstattung und praxisorientierten Projekten erwerben Studierende Kenntnisse, die direkt in Forschung, Entwicklung und Industrie übertragbar sind.
In unsererem Labor kommt modernstes Equipment zum Einsatz.
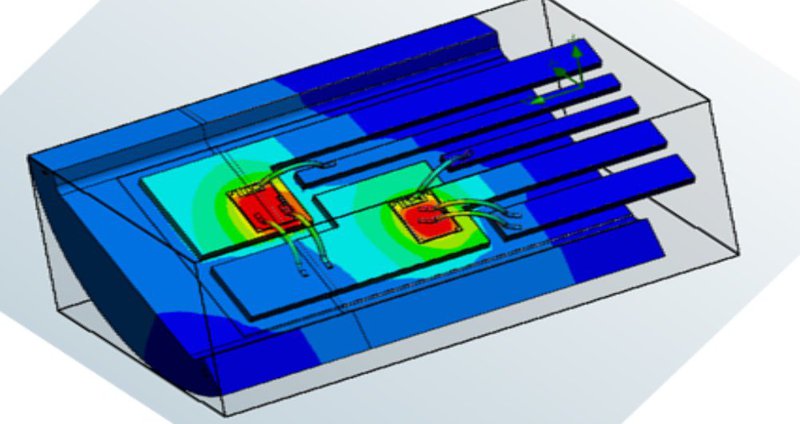
Um erfolgreich aus Ideen funktionale Prototypen zu realisieren wird der Prototyp mittels CAD virtuelle aufgebaut und simuliert.
CAD und Simulation bilden die Grundlage für den gesamten Entwicklungsprozess eines Prototyps. Im 3D-CAD-Modell wird der gesamte Prototyp unteranderem aus Halbleiter-Bauelementen, Leistungsträger (z.B. Metall-Keramik-Substrat) und dem Gehäuse aufgebaut. Darauf aufbauend kann der Prototyp mittels verschiedener Simulationstool der Prototyp thermische, mechanische und elektrisch charakterisiert und optimiert werden.
Ausstattung:
CAD-System: Solidworks
- thermische Simulation (FlowSimulation [CFD], Ansys [FEM])
- Strömungs-Simulation (FlowSimulation [CFD], Ansys [FEM])
- Mechanische Simulation (Ansys [FEM])
- Thermo-mechanische Simulation (Ansys [FEM])Elektrische Simulationen (z.B. parasitärer/ elektrischer Parameter) (Ansys [FEM], LTSpice)
- Multiphysik-Simulationen: Kombination aus verschiedenen Simulationen

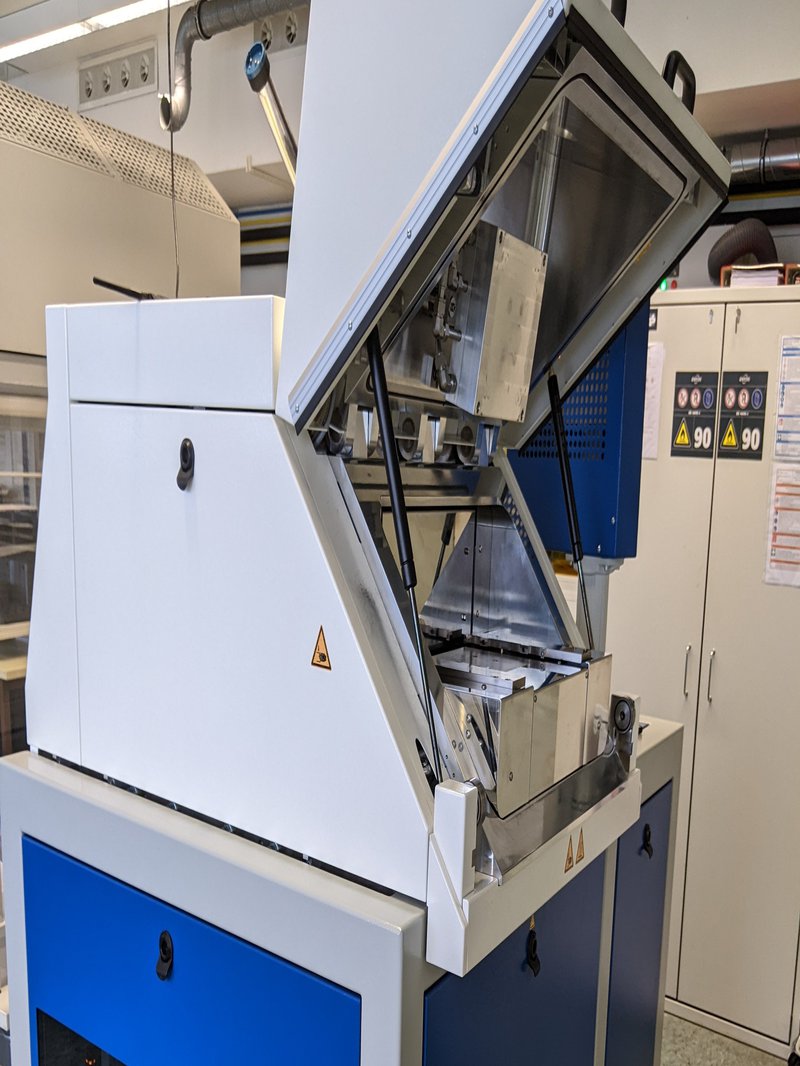



Sintern ist ein Fügeprozess, bei dem Metallpartikel unter Temperatur und oft Druck zu einer festen, leitfähigen Verbindung zwischen Halbleiterchip und Substrat oder Leadframes verdichtet werden. Diese Verbindungsmethode ersetzt zunehmend klassische Lötverbindungen, weil sie höhere Temperaturen, bessere Wärmeleitung und längere Lebensdauer ermöglicht.
- Druckbehaftetes Sintern: besonders dichte, robuste und hochleitfähige und zuverlässige Verbindung, geeignet für Hochleistungsanwendungen.
- Druckloses Sintern: natürliche Oberflächendiffusion durch erhöhte Temperaturen, schonender für empfindliche Bauteile, einfachere Prozessführung, geeignet für Standardanwendungen.
Ablauf:
- Eine Sinterpaste (Silber oder Kupfer) wird auf das Substrat aufgetragen.
- Der Chip wird präzise positioniert.
- Durch Temperatur, Druck und definierte Atmosphäre diffundieren die Metallpartikel zu einer festen, porenarmen Verbindung.
Ausstattung:
- Budatec SP 300
- Budatec VS 220
- 100 Tonnen Presse
- Presse druckloses Sintern
Isolierende und leitfähige Schichten werden zu kompakten, niederinduktiven Substraten verbunden. Studierende lernen, wie unterschiedliche Materialien und Schichtaufbauten die elektrische Leistung, thermische Stabilität und Zuverlässigkeit von Leistungsmodulen beeinflussen. Dabei stehen sowohl moderne Laminierverfahren als auch die Optimierung von Materialkombinationen im Fokus, um effiziente und langlebige Module zu realisieren.
- Elektrische Leistung: Die Schichten führen Strom effizient und reduzieren Induktivität.
- Thermische Stabilität: Wärme kann besser verteilt oder abgeleitet werden, Module werden belastbarer.
- Mechanische Stabilität: Substrate werden widerstandsfähiger gegen Druck, Biegung oder Vibrationen.
- Flächeneinsparung: Mehrschichtige Laminierungen ermöglichen kompakte, leichte Module.
- Zuverlässigkeit: Durch saubere, stabile Verbindung der Materialien sinkt die Ausfallrate.
Ausstattung:
- Laminierpresse Collin Typen Nr.: Lab Line P 300SV, Druckluft 4-6 bar, Wasserdruck 4-6 bar, Max. Hydraulikdruck 250 bar
- Laminierpresse Vogt Typ: LABOPRESS, Wasserdruck 5 bar, Luftdruck 8 bar, Max. Hydraulickdruck 210 bar
- Laborofen Binder
- T-Shirtpresse Helo 24.eu
- Flachbettschneideplotter Mimaki CFL-605RT
- Vakuum- und Temperaturkontrollsysteme
- Schicht- und Dickenmessgeräte
Wir prüfen Leistungsmodule entlang ihrer Prozesskette systematisch auf Qualität, Zuverlässigkeit und Leistung. Zerstörungsfreie Verfahren wie die Ultraschallmikroskopie ermöglichen Einblicke in interne Strukturen, während optische Mikroskopie und Materialanalysen Oberflächen und Materialien detailliert untersuchen. Elektrische Tests prüfen Leitfähigkeit, Isolationswerte und Spannungsfestigkeit, während thermische und mechanische Prüfungen Belastbarkeit der Verbindungsschichten und Prozessfenster erfassen.
Die gewonnenen Daten fließen direkt in die Optimierung von Design, Materialwahl und Fertigungsprozessen ein. So lernen Studierende praxisnah, wie moderne Leistungsmodule zuverlässig, effizient und langlebig gestaltet werden.
Optische Verfahren
- Digitalmikroskopie
- Rasterelektronenmikroskopie (REM)
- Laser-Scanning-Mikroskopie (LSM)
- 3D-Profilometer
Elektrische Untersuchungen
- Ermittlung der Spannungsfestigkeit (bis 5 kV)
- Elektrische Prüfung von Halbleitern (Diode, IGBT, MOSFET)
Thermische Verfahren
- Thermografie zur Analyse von Hotspots
- Rth-Messung von Substraten
- Dynamische Differenzkalorimetrie (DSC)
- Thermogravimetrische Analyse (TGA)
- Thermal Interface Material Analyzer (ASTM D5470)
Mechanische Prüfungen
- Schertest (Halbleiter- und Bondverbindungen)
- Peeltest / Zugtest (Bondverbindungen)
- Ultraschallmikroskopie (SAM)
- Dornbiegeprüfung
Materialanalysen
- Energiedispersiven Röntgenspektroskopie (EDX)
- Laserinduzierte Plasmaspektroskopie (LIPS / LIBS)
Ausstattung:
- Keyence VHX-7000 mit EA-300
- Keyence VHX-1000
- Keyence VR-3200
- Keyence VK-X100
- KSI V300
- Thermo Fisher Scientific Phenom XL
- Quorum Q150R ES PLUS
- Nanotest TIMA 5
- XYZTEC Condor Sigma
- GW instek GPT-12003
- Hitachi NEXTA STA200

Beim Bonden werden elektrische Verbindungen zwischen Chip und Substrat hergestellt. Dafür nutzt man feine Drähte oder Bänder aus Kupfer oder Aluminium. Der Bondprozess ist für die Stromführung entscheidend und muss dauerhaft stabil bleiben – auch unter thermischem Zyklieren, Vibration oder hohen Strömen.
Methoden:
- Keilbonder (Aluminiumdraht): Häufigste Methode in der Leistungselektronik, robust und kosteneffizient.
- Kugelbonder (Golddraht): Wird eher in der Mikroelektronik genutzt (z. B. Sensoren, ICs).
- Kupferbonding: Hohe Leitfähigkeit, hohe Stromtragfähigkeit.
- Ribbon Bonding: Flache Bänder statt runde Drähte, reduziert die Induktivität und erhöht die Strombelastbarkeit.
Ablauf:
- Positionierung der Bondnadel.
- Ultraschallenergie, Druck oder Wärme erzeugen die metallurgische Verbindung.
- Draht wird gespannt, verlegt und am zweiten Kontaktpunkt gebondet.
Ausstattung:
- Orthodynde Electronics Bondmaschine
- Delvotec Keyboard Wirebonder
- XYZTEC Bondtester
- KEYENCE Digital-Mikroskope
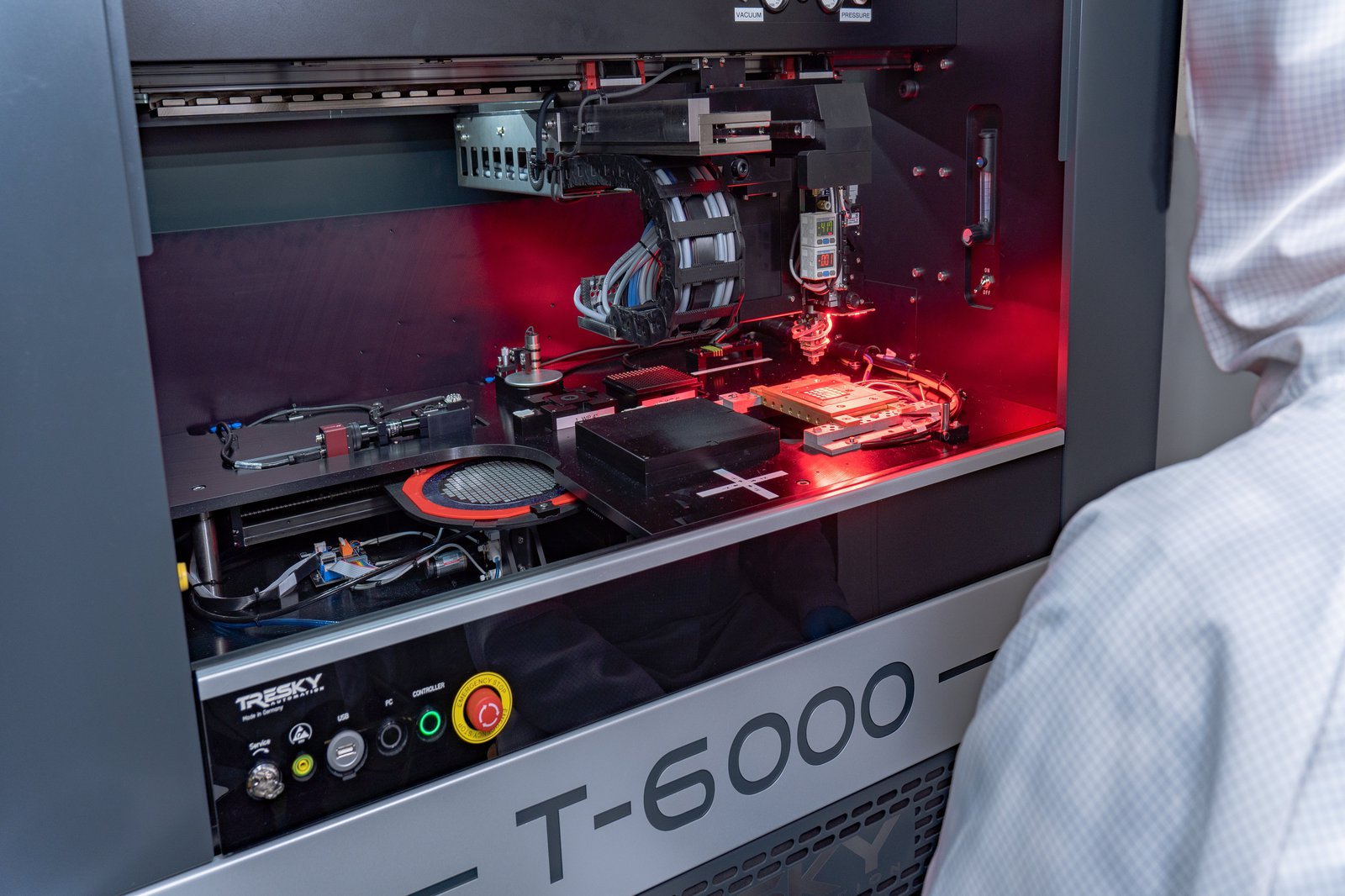
Während des Packagings werden die einzelnen Komponenten des Leistungsmoduls zusammengeführt und sicher eingebettet. Halbleiterchips, Substrate und Bondverbindungen werden in das Gehäuse integriert, anschließend erfolgt das Vergießen oder Einkapseln.
Das Modul wird vergossen oder eingekapselt, um es vor Feuchtigkeit, Staub und mechanischer Belastung zu schützen. Die Wahl der Materialien und Verfahren beeinflusst direkt die Lebensdauer und Zuverlässigkeit.
So entstehen robuste, langlebige Module, die vor Feuchtigkeit, Staub und mechanischen Belastungen geschützt sind.
Ausstattung:
- Rahmendruck: Rapit Prototyping
- Einkapselung
- Molding
- Verguss

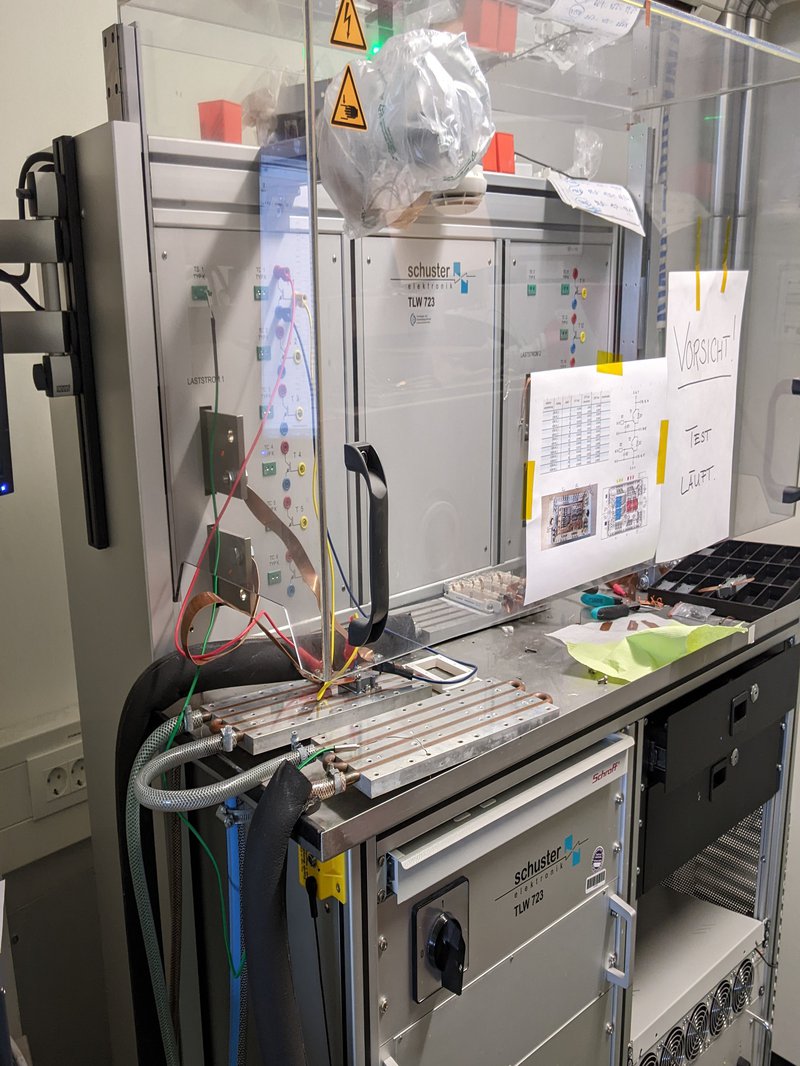
Funktionstests stellen sicher, dass ein Modul tatsächlich das leistet, was die Simulation verspricht. Sie liefern harte Daten zu elektrischen, thermischen und mechanischen Eigenschaften und sind ein fester Bestandteil der Optimierung.
- Temperaturschocktest in Luft & Fluid (TST)
- Power Cycling Test
- H3TRB
- Rth-Messung von Leistungsmodulen / Einzelbaugruppen
- Pump Out Prüfung von TIM-Material
- Deformationsmessung von Leistungsmodulen (thermisch)
Ausstattung:
- H3TRB Prüfstand Schuster Elektronik HTRB 689
- Schuster Elektronik TLW 723
- Pump Out Prüfstand
- TST Prüfstand